Main characteristic index∶
Materials∶
Polypropylene or stainless steel(304);
Options quartz groove;
Microcomputer temperature controller∶
In groove temperature variation <±1.0℃(@50℃);
Outside groove circulating heating system∶
Reliable and easy maintenance;
Overheating and water level alarm, water can be added automatically to maintain the water level;
(electroplating) hanging plating bath,4- point cathode contact;DC/pulse power supply;
Options PLC Touch-screen control;
.jpg)
.jpg)
Magatherm石英槽
.jpg)
过滤系统
.jpg)
循环加热系统
2.2 Precision Diamond Manual Scriber
America Dynatex International
.jpg)
Parameters |
GST-100 |
GST-150 |
| wafer size | Max 100mm | Max 150mm |
| wafer thickness | 40-1725μm(associated with the materials) | |
| scratch width | <5μm | |
| minimum step distance | standard 5μm (options 2μm) | |
| scribing speed | max 100mm/sec | |
| collapse piece speed | 2-4 breaks/sec | |
| collapse piece means | back side rapid air rush rod (British patent) | |
| graphic recognition vision system | auto-registration,pattern recognition,automatic delineation, automatic step and calibrate step error according to the set | |
| materials | GaAs,inP,GaP.Silicon,Saphire,Quartz | |
| user controllable parameters | cutting angle, drag force, scribing speed, entry speed of knife, collapse piece force, any few number core size | |
.jpg)
.jpg)
.jpg)
2.3 Wafer Expander
America Dynatex International
| product characteristics: | |
| size: | wafer size 6" or smaller, 5", 6" or 7" hoop group |
| rapid: | rapid periodic time fix the tape to hoop group and expand |
| precision: | suitable for picking and laying equipment |
| best expansion: | constant temperature control and fully adjustable heating platform optimization expansion |
| clean: | no physical contact between the chip and the controller |
| technical index: | |
| max Hoop group size: | 7" |
| maximum chip size: | 6" |
| temperature range: | 100-450C℃ or 40-230℃ |
.jpg)
.jpg)
2.4 Ball/Wedge Wire Bonding
Germany Technical Product Trade (TPT)

HB30
.jpg)
HB05

HB16
| Manual machine | Semi-automatic--1 | Semi-automatic--2 | Semi-automatic heavy duty aluminum wire | |
| wedge bonding | HB02 | HB06 | HB12 | HB30 |
| ball bonding | HB04 | HBO8 | HB14 | no |
| wedge bonding + ball bonding | HB05 | HB10 | HB16 | no |
| parameters | Manual machine | Semi-automatic--1 | Semi-automatic--2 | Semi-automatic heavy duty aluminum wire |
| wedge bonding | 17-75um | 100-500um | ||
| tape bonding | 25*250um | no | ||
| ball bonding and jump pier bonding | 17-50um | no | ||
| multipoint bonding | no | yes | ||
| direction control | XYZ manual | Z automatic | Z and Y automatic | |
| parameter setting interface | 4.1 inches LCD,hand wheel adjustment | 6.5 inches touch screen | ||
| automatic height | no | yes | ||
| radian control | no | highly controlled | highly and radian controlled | |
| bondarm length | 165mm | |||
| deep mobile | 19mm | |||
| programs stored | 20 | 100 | ||
| wire feed rolls | 2 inches hand-operated | 2 inches electrodynamic | 4 inches hand-operated | |
| fine mobile range | 10*10mm | 15*15mm | ||
| handle and head movement rate | 6:1 | 6:1 (options 3:1) | ||
| ultrasonic frequency | 62khz | |||
| ultrasonic frequency (max) | 5w | 50w | ||
| solder and sample contacting time | 20-1000ms | 15-2000ms | 0-10s | |
| welding force (unit: 1% cN) | 15-130 | 15-150 | 50-1800 | |
| built-in heating stage | 250℃(max) | no | ||
| illuminating system | double LED fiber-optics guided | double halogen lamp fiber-optics guided | ||
| chips Pick & Place | options | no | ||
| built-in tension tester | no | options | no | |
| copper wire welding | options | no | ||
| laser positioning | options | |||
| power requirements | 100-240V/10A | |||
| weight | 29kg | 42kg | 50kg | |
| remarks | HB05=(wedge)+HB04(ball) | HB10=HB06(wedge)+HB08(ball) | HB10=HB12(wedge)+HB14(ball) | |

AS-Micro
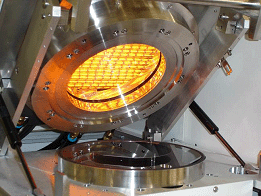
AS-One

AS-Master
| Characteristic | AS-Micro | AS-One 100 | AS-One 150 | AS-Master |
|---|---|---|---|---|
| max substrate dia | 75mm | 100mm | 150mm | 200mm |
| chamber size | 85dia×25mm | 130dia×25mm | 200dia×25mm | 300dia×25mm |
| temperature range | RT-1250℃ | RT-1500℃ | RT-1300℃ | RT-1500℃ |
| heating rate | 0.1-250℃ | 0.1-200℃ | 0.1-150℃ | 0.1-200℃ |
| temperature control | rapid digital PID | rapid digital PID | rapid digital PID | rapid digital PID |
| process gas line | 3 | 5 | 5 | 6 |
| AS-Micro main technology parameters |
|

AS-Micro/more~
| Technology parameters | AS-One 100 | AS-One 150 |
| sample size | 100 mm(") | 150 mm(") |
| vacuum chamber size | 130 mm diameter x 25 mm | 200 mm diameter x 25 mm |
| lamps numbers/max power | 12 / 30 kW | 18 / 34 kW |
| max heating temperature (high temperature options) | 1250C (1500C) | 1200C (1300C) |
| heating rate | 0.1C to 200C/s | 0.1C to 150C/s |
| cooling mode | air cooling | |
| thermocouple | 2 K type(one center and one edge) | |
| cryometer range | 150C to 1100C | |
| pyrometer range | 400C to 1500C | |
| infrared pyrometer | 2 (one center and one edge) | |
| process gas line | max 5 | |
| vacuum range | 10E-3 Torr (Roughing) 10E-6 Torr (Turbo) | |
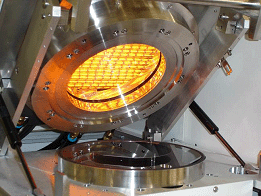
AS-One/more~
| Parameters | S20 | S20 HT | 2000 | 2000HT |
| max temperature | 1150°C | 1500°C | 1250°C | 1500°C |
| heating zone | 6 | 6 | 10 | 10 |
| max power | 75 kW | 105 kW | 90 kW | 105 kW |
| max sample size | 200mm dia or 200mmx200mm rectangle | |||
| vacuum chamber | water-cooling, stainless steel chamber wall, low noise | |||
| heating | infrared partition heating, air cooled the lamp tube | |||
| temperature control | thermocouple and pyrometer control with PID | |||
| vacuum range | 10E-3 Torr (Roughing), 10E-6 Torr (Turbo) | |||
| process gas line | max 6 | |||
| control method | computer control, provide more than 100 processing procedures with different requirements | |||

AS-Master/more~
| Applications | RTA, RTO, Reflow, Implantation annealing… |
| Substrate size | up to 6-inch diameter samples |
| Temperature max | 1300°C (depending on furnace version) |
| Temperature ramp rate | 150°C/s on 4-inch silicon wafer (depending on version) |
| Temperature control | multi-zone, thermocouple or pyrometer, fast PID |
| Vacuum capability | 10-3 Torr (10-6 Torr option) |
| Gas lines | up to 6 gas lines with MFC and one purge line with needle valve |
| Loading | manual, optional cassette to cassette or load-lock |
| Applications | Silicon Carbide implantation annealing, Graphene on SiC… |
| Substrate size | up to 4-inch diameter samples |
| Temperature max | 2000°C up to one hour |
| Temperature ramp rate | 4°C/s up to 1800°C and 2°C/s up to 2000°C |
| Temperature control | thermocouple and pyrometer, fast PID |
| Vacuum capability | 10-6 Torr |
| Gas lines | up to 8 gas lines with MFC and one purge line with needle valve |
| Loading | manual |
2.6 CMP System
Revasum
| Table Motor Size/Cntrl | 5 Hp w/ AC Var.SpeedDrv |
| Table Diameter | 22” [~560mm] |
| Oscillation Stroke | Adjustable |
| Slurry System(s) | 2 Std/ 3rd optional |
| Slurry In/Out | ~3 GPH |
| Dimensions (SAE) | 48”W x 51”D x 72”H |
| Dimensions (Metric) | 1.2M x 1.3M x 1.8M |
| Footprint | ~17 Ft² [~1.57 M²] |
| Weight | ~1800 lbs [~820 K] |
| Wafer Capacity | 100mm to 200mm |
| Control System | PC-DOS 2000 |
| Wafer Handling | Manual Wafer Load |
| Configuration | 1 tables, 1 polish head |

2.7 P8010 Advanced Linear Track System
America C&D Semiconductor Services Inc.
| P8010 Technical Data | |
| Available modules | Coater, developer, hot plates, chill plates, vapor prime |
| Transfer Method | Automatic transfer arm with improved design maintaining end-point placement to within ± 0.1 mm over 300,000 wafers |
| User Interface | Windows-based operating system with smartPro GUI |
| Transfer Mode | Serial transport |
| Indexer | SEMI standard H confguration |
| Coater | Spin motor: 50 RPM-9500 RPM in 10 RPM increments (Optional brushless motor with digital controller) # of Dispenses: Up to four Solvent nozzles: Top and bottom EBR |
| Developer | Spin motor: 50 RPM – 9500 RPM in 10 RPM increments (Optional brushless motor with digital controller) Stream and spray nozzles |
| Hot Plate | Hot plate temperature: Up to 300˚C (optional temperature to 400˚C) Uniformity: ±0.5% (50˚C -300˚C) Bake method: Contact or fxed/programmable proximity options |
| Chill plate | Standard house chilled water Optional high efciency chiller at ambient ± .1˚C – Option |
| Vapor Prime | Temperature range25˚C to 190˚C Method: Programmable and/or fxed proximity bake capability |

2.8 P8060 Copper Bump Developer
America C&D Semiconductor Services Inc.
| P8060 Technical Data | |
| Available modules | Copper bump developer |
| Wafer size | 50 mm - 200 mm wafers |
| Transfer Method | Automatic transfer arm with improved design maintaining end-point placement to within ± 0.1 mm over 300,000 wafers |
| Transfer Mode | Serial transport |
| User Interface | Windows-based operating system with smartPro GUI |
.jpg)
.jpg)
2.9 P8000 Track System
America C&D Semiconductor Services Inc.
| P8000 Technical Data | |
| Available modules | Coater, developer, hot plates, chill plates, vapor prime |
| Wafer Size | 88X 50 mm - 200 mm 86X 50 mm - 150 mm |
| Transfer Method | 88X - Automatic transfer arm 86X - Belt transfer |
| User Interface | Card cage control (with optional Recipe Master for 88X) |
| Transfer Mode | Serial transport |
| Indexer | SEMI standard H confguration |
| Coater | Spin motor: 50 RPM – 9500 RPM in 10 RPM increments (Optional brushless motor with digital controller) # of Dispenses: Up to four Solvent nozzles: Top and bottom EBR |
| Developer | Spin motor: 50 RPM – 9500 RPM in 10 RPM increments (Optional brushless motor with digital controller) Stream and spray nozzles |
| Hot Plate | Hot plate temperature: Up to 300˚C (Optional temperature to 400˚C) Uniformity: ±0.5% (50˚C -300˚C) Bake method: Contact or fxed/programmable proximity |
| Chill plate | Standard house chilled water Optional high efciency chiller at ambient ± .1˚C – Option |
| Vapor Prime | Temperature range25˚C to 190˚C Method: Programmable and/or fxed proximity bake capability |

2.10 P9000 Cluster System
America C&D Semiconductor Services Inc.
| P9000 Technical Data | |
| Feature Sizes | ≥ .35μ Resist dependent and assumes temperature/humidity control within fab of ±1.0ºC and ± 3% relative humidity. |
| User Interface | Windows-based operating system with smartPro GUI |
| MTBF | ≥ 500 hrs, or 12,000 wafers (Based on C&D’s PM schedule) |
| MTTR | ≤ 1 hour |
| Uptime | 95% or better |
| Wafers Broken | 1 in 10,000 wafers |
| Reliability | 95% uptime in volume process manufacturing |
| System throughput | 100+ wafers per hour (Configuration & Process Dependent) |
.jpg)
.jpg)
2.11 P7000 Efficient Alloying Furnace
America C&D Semiconductor Services Inc.
| Model | SmartPro P7000 |
| wafer size | 2-8inches |
| temperature | up to 500°C |
| speed | 20piece/h |
| major advantage | reliable, simple and efficient, realized the chip box (C to C) function |
| infinitely close heating mode,heating plate non-touch the back of wafer, low warping, high uniformity and high repeatability | |
| multiple gas, controlled environment and slow cooling | |
| by varying the distance between the wafer and the heating plate to control the heating rate | |
| manual and automatic control, efficient, twice as efficient as RTA | |
| higher cost performance |
.jpg)
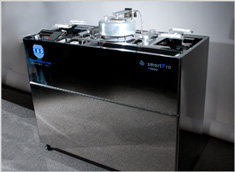
| Model | MC050 | MC100 | MC200 |
| wafer size | 2 inches | 4 inches | 8 inches |
| applications |
semiconductor: SiO2, HfO2, Ta2O5, Cu, TiN, TaN, ... |
||
| temperature | up to 1200°C | up to 850°C | up to 850°C |
| vacuum | barometric pressure——10E-3 Torr | ||
| evaporator | up to 6 | up to 4 | up to 4 |
| gas circuit | Up to 6,MFC control | ||
| process chamber | quartz tube (water-cooled stainless steel flange) | controllable temperature stainless steel wall, rotating sample seat | controllable temperature stainless steel wall, rotating sample seat |
| heat | halogen lamp | resistance wire | resistance wire |
| temperature control | fully digitized PID control | ||

| Model | SprayCVD 050 (also used for annealing) |
| wafer size | 2*2 inches |
| applications |
implantation annealing |
| temperature | room temperature——1200°C |
| vacuum | barometric pressure——10E-3 Torr |
| gas circuit | up to 3, MFC control |
| process chamber | quartz tube (water-cooled stainless steel flange) |
| heat | halogen lamp (upper and lower heating modes are available) |
| temperature control | fully digitized PID control |

| Model | Benchark 800 |
| characteristic | 1—8 inches |
| up to 6 process gases, MFC control | |
| equipped with a water-cooled electrode for ion etching | |
| hot bottom electrode plate and water-cooled electrode plate,used to enhance PECVD | |
| etch (SiO2&Si3N4):100°C/1500 2000Amin/ Uniformity +/-5% | |
| enhanced plasma CVD(PECVD)(SiO2&Si3N4):300°C/500Amin/ uniformity +/-5% |

| Model | PlasmaStar |
| characteristic | 12 inches * 14 inches plasma region |
| up to 4 process gases, MFC control | |
| parallel electrodes, upper electrode with a spray head,lower electrode with the function of water cooling | |
| optional cage electrode |

| Model | PlasmaStar |
| characteristic | 12 inches * 14 inches Plasma region |
| up to 4 process gases, MFC control | |
| parallel electrodes, upper electrode with a spray head,lower electrode with the function of water cooling | |
| optional cage electrode |