2.1 化学清洗工作台/电镀台
主要特性指标包括∶
材料∶
聚丙烯(Polypropylene)或不锈钢(304);
石英槽为选项;
微电脑温度控制器∶
槽内温度变化〈±1.0℃(@50℃ );
槽外循环式加热系统∶
可靠易维护;
有过热和水位报警,并可自动加水以维持水位;
(电镀)悬挂式镀槽,4-点阴极接触;直流/脉冲电源;
PLC触屏式控制为选项;
.jpg)
.jpg)
Magatherm石英槽
.jpg)
过滤系统
.jpg)
循环加热系统
2.2 金刚刀解理划片机
Precision Diamond Manual Scriber
美国戴拿特公司(Dynatex International)
.jpg)
技术指标 |
GST-100 |
GST-150 |
| 晶园片大小: | 最大100mm | 最大150mm |
| 晶园片厚度: | 40-1725μm(与材料有关) | |
| 划痕宽度: | <5μm | |
| 最小步进距离: | 标配5μm(选项2μm) | |
| 划片速度: | 最大100mm/sec | |
| 崩片速度: | 2-4 breaks/sec | |
| 崩片方法: | 背面快速气冲杆(Dynatex的英国专利) | |
| 图形识别视觉系统: | 自动对准,图形识别,自动探边按设置自动步进及自动校准步进误差 | |
| 适用的材料: | GaAs,inP,GaP.Silicon,Saphire,Quartz | |
| 用户可控制的参数: | 刀的划片角,下划力,划片速度,刀的进入速度,崩片力度,任意多个管芯尺寸 | |
.jpg)
.jpg)
.jpg)
2.3 晶园扩张器
Wafer Expander
美国戴拿特公司(Dynatex International)
| 产品特性: | |
| 大量尺寸: | 晶片6"直径或更小,5",6"或7" hoop组 |
| 快速: | 快速的周期时间用于将tape固定到hoop组上并扩张。 |
| 精确: | 适合用于取放设备 |
| 最佳扩张: | 恒温控制以及完全可调整加热平台最佳化扩张 |
| 清洁: | 晶片表面和控制器没有物理接触 |
| 技术指标: | |
| 最大HOOP组尺寸: | 7" |
| 最大晶片尺寸: | 6" |
| 温度范围: | 100-450C℃或者40-230℃ |
.jpg)
.jpg)
2.4 球形、楔形键合台
Ball/Wedge Wire Bonding
德国TPT公司(Technical Product Trade)

HB30
.jpg)
HB05

HB16
| 手动机型 | 半自动一型 | 半自动二型 | 半自动重型铝丝 | |
| 楔焊 | HB02 | HB06 | HB12 | HB30 |
| 球焊 | HB04 | HBO8 | HB14 | 无 |
| 楔焊+球焊 | HB05 | HB10 | HB16 | 无 |
| 指标 | 手动机型 | 半自动一型 | 半自动二型 | 半自动重型铝丝 |
| 楔焊 | 17-75微米 | 100-500微米 | ||
| 带焊 | 25*250微米 | 无 | ||
| 球焊和跳墩焊 | 17-50微米 | 无 | ||
| 多点联焊 | 无 | 有 | ||
| 方向控制 | XYZ手动 | Z向自动 | Z和Y向自动 | |
| 参数设置界面 | 4.1寸液晶显示,手轮调节 | 6.5寸触摸屏 | ||
| 自动高度 | 无 | 有 | ||
| 弧度控制 | 无 | 高度可控 | 高度和弧度可控 | |
| Bondarm悬臂长度 | 165mm | |||
| 众深移动 | 19mm | |||
| 程序储存 | 20套 | 100套 | ||
| 送丝轮 | 2寸手摇式 | 2寸电动式 | 4寸手摇式 | |
| 精细移动范围 | 10*10mm | 15*15mm | ||
| 手柄和焊头移动比率 | 6:1 | 6:1(选项3:1) | ||
| 超声频率 | 62千赫兹 | |||
| 超声功率(最大) | 5瓦 | 50瓦 | ||
| 焊点接触样品时间 | 20-1000毫秒 | 15-2000毫秒 | 0-10秒 | |
| 焊接力道(剪切力单位:1%牛顿cN) | 15-130 | 15-150 | 50-1800 | |
| 内置热台加热能力 | 250℃(最大) | 无 | ||
| 照明系统 | 双LED光纤导照 | 双内置卤素灯光纤导照 | ||
| 管芯取放(Pick&Place) | 选项 | 无 | ||
| 内置拉力测试仪 | 无 | 选项 | 无 | |
| 铜线焊接 | 选项 | 无 | ||
| 激光定位 | 选项 | |||
| 电力要求 | 100-240V/10A | |||
| 重量 | 29kg | 42kg | 50kg | |
| 备注 | HB05=(楔)+HB04(球) | HB10=HB06(楔)+HB08(球) | HB10=HB12(楔)+HB14(球) | |
2.5 RTP RTCVD
Rapid Thermal Process/Rapid Thermal Chemical Vapor Deposition
法国AnnealSys公司/more

AS-Micro
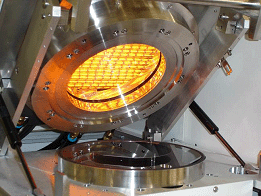
AS-One

AS-Master
| 指标特点 | AS-Micro | AS-One 100 | AS-One 150 | AS-Master |
|---|---|---|---|---|
| 最大衬底直径 | 75mm | 100mm | 150mm | 200mm |
| 腔体尺寸 | 85直径×25mm | 130直径×25mm | 200直径×25mm | 300直径×25mm |
| 温度范围 | RT-1250℃ | RT-1500℃ | RT-1300℃ | RT-1500℃ |
| 升温速率 | 0.1-250℃ | 0.1-200℃ | 0.1-150℃ | 0.1-200℃ |
| 温度控制 | 快速数字PID | 快速数字PID | 快速数字PID | 快速数字PID |
| 工艺气体管路 | 3 | 5 | 5 | 6 |
| AS-Micro 主要技术指标 |
|
| 指标项目 | AS-One 100 | AS-One 150 |
| 样品尺寸 | 100 mm (4") | 150 mm (6") |
| 真空腔室尺寸 | 130 mm diameter x 25 mm | 200 mm diameter x 25 mm |
| 灯管数 /最大功率 | 12 / 30 kW | 18 / 34 kW |
| 最高升温温度(高温选项) | 1250C (1500C) | 1200C (1300C) |
| 升温速率 | 0.1C to 200C/s | 0.1C to 150C/s |
| 冷却方式 | 风冷 | |
| 热电偶 | 2 个K 型( 中心和边缘各一个) | |
| 低温计量程 | 150C to 1100C | |
| 高温计量程 | 400C to 1500C | |
| 红外高低温计 | 2个(中心和边缘各一个) | |
| 气路数量 | 最高5路 | |
| 真空 | 10E-3 Torr (Roughing) 10E-6 Torr (Turbo) | |
| 指标项目 | S20 | S20 HT | 2000 | 2000HT |
| 最高温度 | 1150°C | 1500°C | 1250°C | 1500°C |
| 加热区域 | 6 | 6 | 10 | 10 |
| 最大功率 | 75 kW | 105 kW | 90 kW | 105 kW |
| 最大样品尺寸 | 200mm直径或200mmx200mm 矩形 | |||
| 真空腔室 | 水冷,不锈钢腔壁,低噪音。 | |||
| 加热 | 红外线分区加热,空气风冷却灯管 | |||
| 温度控制 | 热电偶和高温计PID控制 | |||
| 真空 | 10E-3 Torr(Roughing),10E-6 Torr(Turbo) | |||
| 气路数量 | 最高6路 | |||
| 控制方式 | 计算机控制,提供超过100个不同要求处理工艺程序 | |||
| Applications | RTA, RTO, Reflow, Implantation annealing… |
| Substrate size | up to 6-inch diameter samples |
| Temperature max | 1300°C (depending on furnace version) |
| Temperature ramp rate | 150°C/s on 4-inch silicon wafer (depending on version) |
| Temperature control | multi-zone, thermocouple or pyrometer, fast PID |
| Vacuum capability | 10-3 Torr (10-6 Torr option) |
| Gas lines | up to 6 gas lines with MFC and one purge line with needle valve |
| Loading | manual, optional cassette to cassette or load-lock |
| Applications | Silicon Carbide implantation annealing, Graphene on SiC… |
| Substrate size | up to 4-inch diameter samples |
| Temperature max | 2000°C up to one hour |
| Temperature ramp rate | 4°C/s up to 1800°C and 2°C/s up to 2000°C |
| Temperature control | thermocouple and pyrometer, fast PID |
| Vacuum capability | 10-6 Torr |
| Gas lines | up to 8 gas lines with MFC and one purge line with needle valve |
| Loading | manual |
2.6 CMP System
Revasum
| Table Motor Size/Cntrl | 5 Hp w/ AC Var.SpeedDrv |
| Table Diameter | 22” [~560mm] |
| Oscillation Stroke | Adjustable |
| Slurry System(s) | 2 Std/ 3rd optional |
| Slurry In/Out | ~3 GPH |
| Dimensions (SAE) | 48”W x 51”D x 72”H |
| Dimensions (Metric) | 1.2M x 1.3M x 1.8M |
| Footprint | ~17 Ft² [~1.57 M²] |
| Weight | ~1800 lbs [~820 K] |
| Wafer Capacity | 100mm to 200mm |
| Control System | PC-DOS 2000 |
| Wafer Handling | Manual Wafer Load |
| Configuration | 1 tables, 1 polish head |

6EC-II CMP System
| Table Motor Size/Cntrl | 36 Motor Load Amps |
| Table Speed | 0-185 RPM |
| Table Diameter | 28” |
| Downforce Range | 0-9 psi |
| Polishing Force Range | 0-9 psi |
| Oscillation Stroke | 0-6” |
| Oscillation Frequency | 0-12 cpm |
| Slurry System(s) | 3 max, 0-1000 ml/min |
| Slurry Flow Range | 0-1000 ml/min |
| Slurry Flush | YES |
| Pad Conditioning Disk | 0-50 RPM |
| Pad Conditioning Sweep | 0-10 sec per segment |
| Slurry In/Out | 20 PSI (max) |
| Dimensions (SAE) | 100”W x 75”D x 79”H |
| Dimensions (Metric) | 2.54M x 1.75M x 2.0M |
| Footprint | ~48 Ft² [~4.5 M²] |
| Weight | ~8500 lbs [~3865 K] |
| Wafer Capacity | 100mm to 200mm |
| Control System | PC-DOS 2000 |
| Wafer Handling | Cassette->Cassette,(auto) |
| Confguration | 2 tables, 2 polish heads per table |

6DS-SP CMP System
2.7 高效涂胶显影一体机
P8010 Advanced Linear Track System
美国 C&D 公司(C&D Semiconductor Services Inc.)
| P8010 Technical Data | |
| Available modules | Coater, developer, hot plates, chill plates, vapor prime |
| Transfer Method | Automatic transfer arm with improved design maintaining end-point placement to within ± 0.1 mm over 300,000 wafers |
| User Interface | Windows-based operating system with smartPro GUI |
| Transfer Mode | Serial transport |
| Indexer | SEMI standard H confguration |
| Coater | Spin motor: 50 RPM-9500 RPM in 10 RPM increments (Optional brushless motor with digital controller) # of Dispenses: Up to four Solvent nozzles: Top and bottom EBR |
| Developer | Spin motor: 50 RPM – 9500 RPM in 10 RPM increments (Optional brushless motor with digital controller) Stream and spray nozzles |
| Hot Plate | Hot plate temperature: Up to 300˚C (optional temperature to 400˚C) Uniformity: ±0.5% (50˚C -300˚C) Bake method: Contact or fxed/programmable proximity options |
| Chill plate | Standard house chilled water Optional high efciency chiller at ambient ± .1˚C – Option |
| Vapor Prime | Temperature range25˚C to 190˚C Method: Programmable and/or fxed proximity bake capability |

2.8 铜凸点金属膜显影机
P8060 Copper Bump Developer
美国 C&D 公司(C&D Semiconductor Services Inc.)
| P8060 Technical Data | |
| Available modules | Copper bump developer |
| Wafer size | 50 mm - 200 mm wafers |
| Transfer Method | Automatic transfer arm with improved design maintaining end-point placement to within ± 0.1 mm over 300,000 wafers |
| Transfer Mode | Serial transport |
| User Interface | Windows-based operating system with smartPro GUI |
.jpg)
.jpg)
2.9 高性价比涂胶显影一体机
P8000 Track System
美国 C&D 公司(C&D Semiconductor Services Inc.)
| P8000 Technical Data | |
| Available modules | Coater, developer, hot plates, chill plates, vapor prime |
| Wafer Size | 88X 50 mm - 200 mm 86X 50 mm - 150 mm |
| Transfer Method | 88X - Automatic transfer arm 86X - Belt transfer |
| User Interface | Card cage control (with optional Recipe Master for 88X) |
| Transfer Mode | Serial transport |
| Indexer | SEMI standard H confguration |
| Coater | Spin motor: 50 RPM – 9500 RPM in 10 RPM increments (Optional brushless motor with digital controller) # of Dispenses: Up to four Solvent nozzles: Top and bottom EBR |
| Developer | Spin motor: 50 RPM – 9500 RPM in 10 RPM increments (Optional brushless motor with digital controller) Stream and spray nozzles |
| Hot Plate | Hot plate temperature: Up to 300˚C (Optional temperature to 400˚C) Uniformity: ±0.5% (50˚C -300˚C) Bake method: Contact or fxed/programmable proximity |
| Chill plate | Standard house chilled water Optional high efciency chiller at ambient ± .1˚C – Option |
| Vapor Prime | Temperature range25˚C to 190˚C Method: Programmable and/or fxed proximity bake capability |

2.10 涂胶显影簇群系统
P9000 Cluster System
美国 C&D 公司(C&D Semiconductor Services Inc.)
| P9000 Technical Data | |
| Feature Sizes | ≥ .35μ Resist dependent and assumes temperature/humidity control within fab of ±1.0ºC and ± 3% relative humidity. |
| User Interface | Windows-based operating system with smartPro GUI |
| MTBF | ≥ 500 hrs, or 12,000 wafers (Based on C&D’s PM schedule) |
| MTTR | ≤ 1 hour |
| Uptime | 95% or better |
| Wafers Broken | 1 in 10,000 wafers |
| Reliability | 95% uptime in volume process manufacturing |
| System throughput | 100+ wafers per hour (Configuration & Process Dependent) |
.jpg)
.jpg)
2.11 P7000 高效合金炉
Efficient Alloying Furnace
美国 C&D 公司(C&D Semiconductor Services Inc.)
| 型号 | SmartPro P7000 |
| 晶圆尺寸 | 2 到 8英寸 |
| 温度 | 可达500°C |
| 速度 | 典型20片/小时 |
| 主要优点 | 可靠、操作简单、高效、实现了片盒(C to C)功能 |
| 无限接近加热方式,加热板不接触晶片背面,实现低翘曲 无、高均匀性和高重复性 | |
| 多路气体,实现可控环境和缓冷却 | |
| 升降温速率通过变化晶片到加热板的距离实现,控制精确、简单,反应快 | |
| 可手动和全自动控制,效率高,一般为RTA处理效率的两倍 | |
| 高性价比,价格和比普通RTA低 |
.jpg)
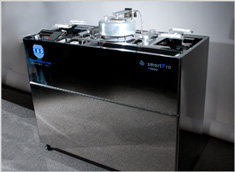
| 型号 | MC050 | MC100 | MC200 |
| 晶圆尺寸 | 2英寸 | 4 英寸 | 8英寸 |
| 应用 |
半导体: SiO2, HfO2, Ta2O5, Cu, TiN, TaN, ... |
||
| 温度 | up to 1200°C | up to 850°C | up to 850°C |
| 真空 | 大气压——10E-3 Torr | ||
| 蒸发器 | 多达6路 | 多达4路 | 多达4路 |
| 气路 | 多达6路,MFC控制 | ||
| 工艺腔 | 石英管(配水冷不锈钢法兰) | 可控温不锈钢冷壁,可旋转样品座 | 可控温不锈钢冷壁,可旋转样品座 |
| 加热 | 卤素灯 | 电阻丝 | 电阻丝 |
| 温度控制 | 完全数字化PID控制 | ||
| 型号 | SprayCVD 050 (可同时用于退火) |
| 晶圆尺寸 | 2*2 英寸 |
| 应用 |
离子注入后退火 |
| 温度 | 室温——1200°C |
| 真空 | 大气压——10E-3 Torr |
| 气路 | 多达3路,MFC控制 |
| 工艺腔 | 石英管(配水冷不锈钢法兰) |
| 加热 | 卤素灯(可选上、下加热方式) |
| 温度控制 | 完全数字化PID控制 |

2.14 BenchMark 800 RIE & PECVD
BenchMark 800 Reactive Ion Etching & Plasma Enhanced Chemical Vapor Deposition
美国Axic公司
| 型号 | Benchark 800 |
| 特点 | 1——8英寸 |
| 多至6路工艺气体,带MFC控制 | |
| 配备反应离子刻蚀的水冷电极 | |
| 热底电极板和水冷上电极板,用于增强等离子体化学气相淀积(PECVD) | |
| 刻蚀(SiO2&Si3N4):100°C/1500 2000Amin/均匀性+/-5% | |
| 增强等离子体CVD(PECVD)(SiO2&Si3N4):300°C/500Amin/均匀性+/-5% |

2.15 PlasmaStar RIE & PECVD
PlasmaStar Reactive Ion Etching & Plasma Enhanced Chemical Vapor Deposition
美国Axic公司
| 型号 | PlasmaStar |
| 特点 | 12英寸*14英寸等离子体区域 |
| 多至4路工艺气体,带MFC控制 | |
| 采用平行电极,上电极带有喷雾头,下电极具备水冷功能 | |
| 可选笼式电极 |

| 型号 | PlasmaStar |
| 特点 | 12英寸*14英寸等离子体区域 |
| 多至4路工艺气体,带MFC控制 | |
| 采用平行电极,上电极带有喷雾头,下电极具备水冷功能 | |
| 可选笼式电极 |